市販されるデスクトップ型粉末X線回折装置としては,Bruker Phaser と Panalytical Aeris, Rigaku MiniFlex が代表的である。
フェイザとエアリス,ミニフレックスには共通して半導体ストリップ型 (PIN フォトダイオード・アレイ型) X線検出器 (semiconductor-strip type X-ray detector; SSXD) が装備される。このタイプの装置のデザインはゼロ次元X線検出器を用いたブラッグ・ブレンターノ型デザインとは少し異なるが,高精度の回折強度測定が必要でない状況ではブラッグ・ブレンターノ型回折装置とほぼ同等の機能を示し,検出効率は従来型装置の 100 倍以上とみなせる場合が多い。このタイプの装置を「擬似ブラッグ・ブレンターノ型装置」と呼ぶこととする。
2025年11月6日にPanalytical Aeris を試用する機会を得た。過去にRigaku MiniFlex を用いて取得したデータと比較した。
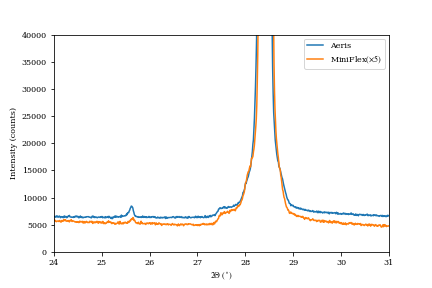
Figure 1 Aeris と MiniFlex を用いて収集された Si 111 回折ピークの強度図形。Aeris の強度に比べMiniFlex の強度は概ね 1/5 程度なので,カウント数を 5 倍した値を示している。MiniFlex での強度の低下は,主にソーラ・スリットの開き角が狭いことによる。
Aeris と MiniFlex を用いて記録された Si 111 反射のピーク形状を上図 (Figure 1) に示す。CuKα1 X線による Si 111 回折ピークは 2Θ〜28.4º 付近に現れる。2Θ〜25.6º 付近に現れる弱いピークは CuKβ X線による Si 111 回折ピークに対応する。 2Θ〜27.4º 付近に現れる段構造 (step like structure) は Ni K 吸収端 (K-absorption edge) 付近での実質的なX線分光強度分布 (spectroscopic distribution) の変化の影響による。
Aeris と MiniFlex のデザインは概ね共通しているが,背景強度(バックグラウンド強度)を低減するための構造物の違いは目立つ。Airis では背景強度を低減するためにナイフエッジ型の散乱プロテクタが用いられるが, MiniFlex では検出器の上流側検出器アームに庇(ひさし)状の散乱プロテクタが設置される。
Airis に装着されるナイフエッジ型散乱プロテクタは,設定によってはX線ビームに干渉する。Figure 1 に示したX線回折データを得た設定では 2Θ 角度が 120º 以上の領域での観測強度が実質ゼロ・カウントになった。 MiniFlex に標準的に設置される庇型散乱プロテクタは全角度域でX線ビームには干渉しない。
Figure 1 のように,低角での相対背景強度について,庇型散乱プロテクタを装備した MiniFlex はナイフエッジ型散乱プロテクタを装備した Aeris と同等かむしろ低い値を示した。
Aeris を用いて取得された粉末X線回折 (XRD) データに逆畳込的処理を施した。逆畳込的処理は (1) X線分光強度分布の影響と (2) 光学的な装置収差の影響とを無効化する。
X線分光強度分布の影響は,対数正弦尺度 ( ln(sinΘ) ) 上で,減衰された Cu Kβ ピークと Ni K 吸収端を含む現実的な分光強度分布 (e.g. Ida, 2020a) について逆畳込を行い,Cu Kα1 位置に設置した仮想的な単一ローレンツ型ピーク形状を畳み込む一段階の操作で無効化される。
装置収差の影響は装置収差函数の1階と3階のキュムラントを数値計算により求め,モデル装置函数ごとに異なる適切な尺度の上で観測強度のフーリエ変換をモデル装置函数のフーリエ変換で除し,モデル装置函数のフーリエ変換の複素絶対値を乗じてから逆フーリエ変換をすることにより無効化される。

Figure 2 Aeris により取得された粉末 XRD データに逆畳込的処理を施す前 (Raw) と後 (DCT) の強度図形の変化(比較的低角の領域)
Figure 2 に逆畳込的処理による比較的低角の領域での XRD 強度図形の変化を示す。CuKβ 輻射に由来する微小ピークと Ni K 吸収端に由来する段構造は,X線分光強度分布についての逆畳込的処理により効果的に除去された。

Figure 3 Aeris により取得された粉末 XRD データに逆畳込的処理を施す前 (Raw) と後 (DCT) の強度図形の変化(比較的高角の領域)
Figure 3 に逆畳込的処理による比較的高角の領域での XRD 強度図形の変化を示す。CuKα2 輻射に由来する副ピークもX線分光強度分布についての逆畳込的処理により効果的に除去される。
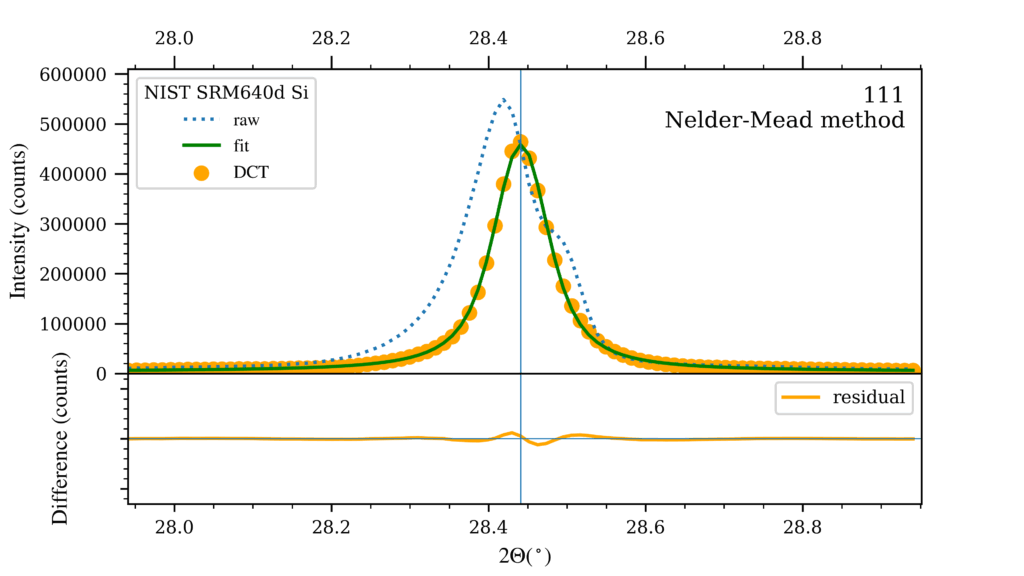
Figure 4 Aeris により取得された XRD データ中 Si 111 反射ピーク付近の強度データ (raw) と逆畳込的処理後の回折図形 (DCT), Voigt 函数ピーク形状をあてはめた曲線 (fit)
Figure 4 に Aeris により取得された Si 111 反射ピーク付近の回折強度図形の変化を示す。NIST SRM640d 標準 Si 粉末の保証書に記載されたピーク位置を縦線で示す。Aeris の出力する回折図形のピーク位置は低角側にずれているように見える。この角度領域では軸発散収差の影響からも,赤道・透過性収差の影響からも低角側へのシフトが予想されるので,このこと自体は合理的に解釈できる。
MiniFlex により取得された XRD データに対する逆畳込的処理では,独自に開発した角度較正ソフトウェアを援用することでピーク位置は概ね修正されたが,Si 111 反射については逆畳込的処理後もピーク形状に明確な非対称性が残る結果となった。Aeris により取得された XRD データはこれと対照的であり,出力されるデータに特別な加工を施さなくても,逆畳込的処理を適用するだけで Si 111 反射についても処理後の図形は左右対称な単一ピーク形状になり,ピーク位置は NIST SRM640c 保証書記載値と一致した。
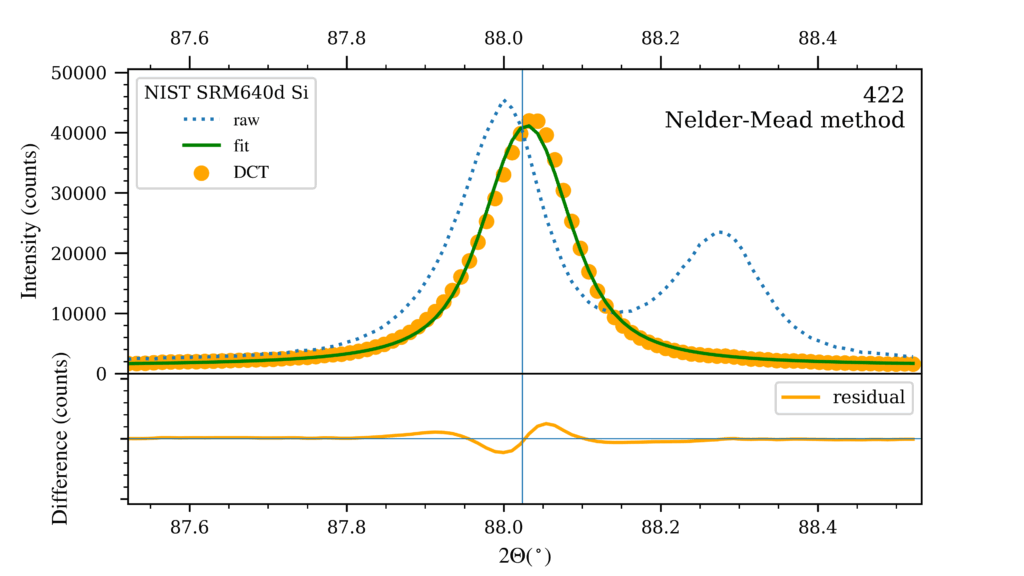
Figure 5 Aeris により取得された XRD データ中 Si 422 反射ピーク付近の強度データ (raw) と逆畳込的処理後の回折図形 (DCT), Voigt 函数ピーク形状をあてはめた曲線 (fit)
Figure 5 に Aeris により取得されたデータ中 Si 422 反射ピーク付近の回折強度図形の変化を示す。この角度領域では,主に透過性収差の影響による低角側へのシフトと低角側へ長い裾を引く非対称な変形が予想される。逆畳込的処理後の図形はわずかなピーク位置ずれと非対称性を残す。試料が焼結体であったことから,嵩密度の実測は省略し,逆畳込的処理では結晶粒の空間充填率を 100% と仮定した。充填率が低ければ透過性収差の影響は強調されることになり,今回の処理では透過性収差が過小に評価されている可能性がある。
Aeris では測定の際に標準的に回転試料台が用いられる。半導体ストリップ型X線検出器の連続走査積算測定 (continuous-scan integration of semiconductor-strip type X-ray detector; CSI-SSXD)では非回転試料でも十分な統計精度が得られるので,回転試料台を用いることの意図を理解していなかったが,強度のサンプリングと非同期の面内回転,複数回走査と積算を組み合わせれば,CSI-SSXD 測定であっても実験的な統計誤差評価を実現できる可能性があるように思われる。
Leave a Reply